<MOSFET scaling>
[Moore's law]

매 2년마다 집적회로의 집적도가 2배씩 증가
=> 하지만, 현재에는 한계가 온 상태!
[scaling down의 이점]
MOSFET의 scale이 K배만큼 감소
-> 'Circuit delay time'은 1/k이 됨
'Power dissipation'은 1/K2이 됨

'current density'는 K가 됨

'Power density'는 1이 됨

=> 집적도, 속도, 전력 소모 등의 향상
[Short Channel Effect]
MOSFET에서 source와 drain사이의 거리가 좁아짐
-> 전류 조절 기능 상실
<Hot electron effect>
- 원인
- transistor size가 작아짐
-> channel의 길이가 짧아짐
-> electric field가 강해짐
-> 전자가 매우 높은 운동E를 얻음
- 영향
- 일부 hot electron
Si-SiO2 간의 포텐셜 장벽을 뛰어 넘음
-> Gate 절연층으로 이동하여, Gate 전류 성분이 될 수 있음

- 일부 전자
게이트 절연층에 trap되어 fixed oxide가 될 수 있음
-> VT 증가
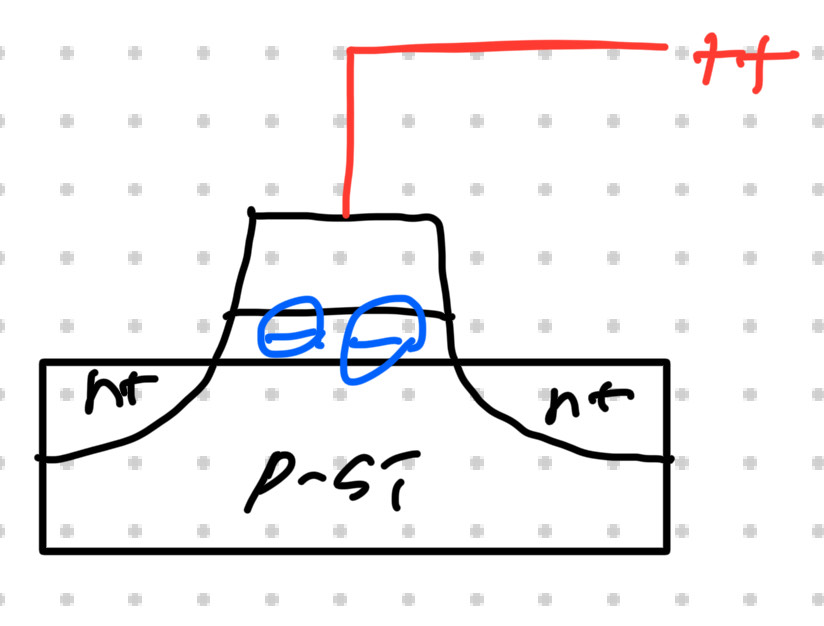
- 큰 에너지를 가진 hot carrier들이 Si-SiO2 경계에서의 Si-H 결합을 깨뜨려 fast interface 상태를 만들 수 있음
cf) Si-H 결합
-> gm과 substrate swing과 같은FET 특성 저하
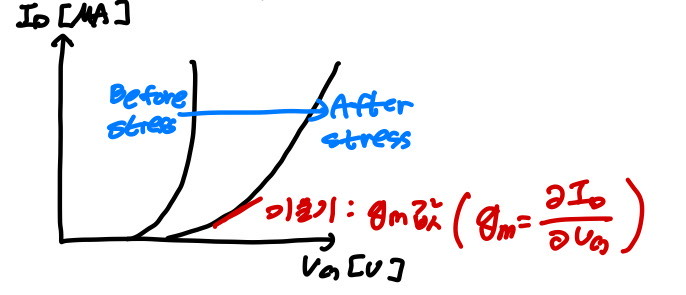
- 해결방안
- Lightly Doped Drain (LDD)
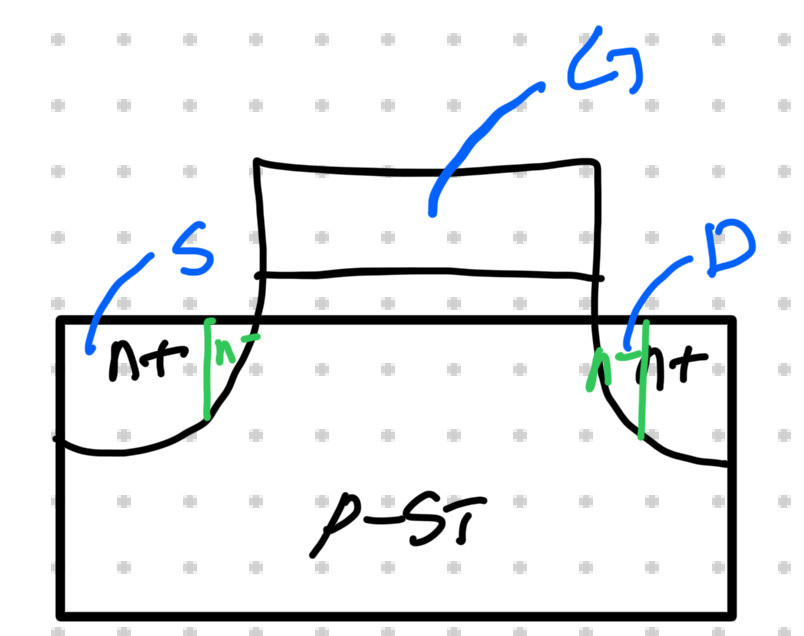
channel과 맞닿는 source와 drain 영역의 도핑 농도를 낮게 힘
-> 역방향 전압이 걸린 drain-channel 접합의 depletion 폭이 증가
-> 전기장 완화
- 공정 방법
spacer 활용
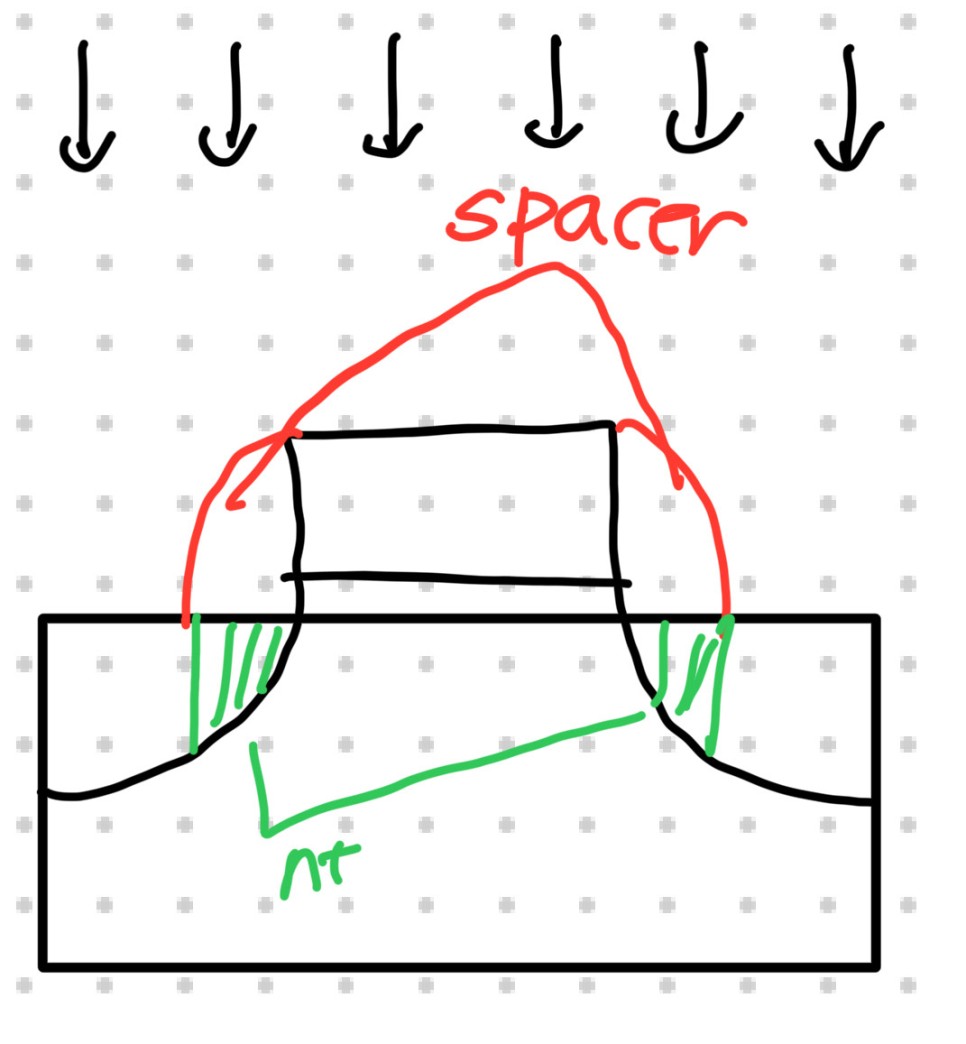
<Drain-induced barrier lowering(DIBL)>
- 원인
- Source와 Drain 사이의 punch-through 또는 breakdown으로 인한 게이트 조절 능력 상실
=> 1) Long Channel
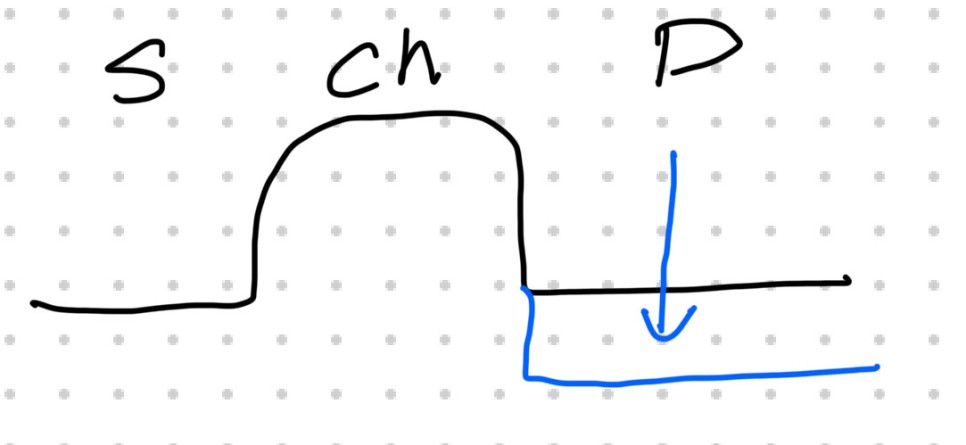
VD가 Source에서 Channel로의 포텐셜 장벽에 영향xxx
2) Short Channel
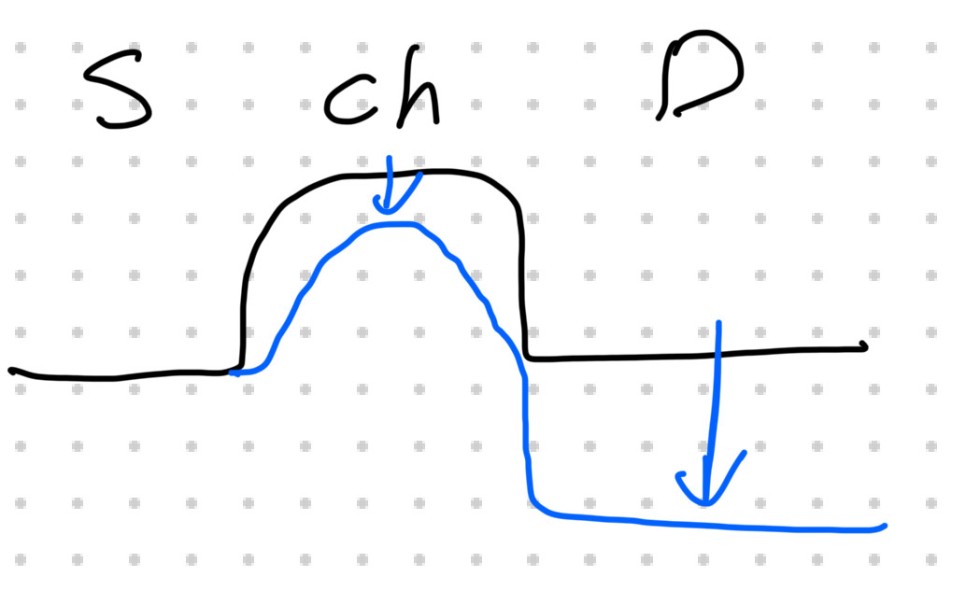
VD가 증가하면서 drain쪽의 EC를 끌어당겨 Source에서 Channel로의 포텐셜 장벽을 낮아지게 함
- 해결방안
- source와 drain의 도핑을 얕게 생성
- halo impant
부분적으로 P도핑을 해줌으로써 deplation영역을 body쪽으로 확장시키는 것을 방지
- punchthrough가 발생하지 않게 채널 도핑을 충분히 높게 함
<Short channel length modulation>
- pinch-off 영역의 길이 △L을 고려하면 유효 Channel의 길이는 L- △L
(∵Pinch-off가 발생하면 Channel이 끊기기 때문!)
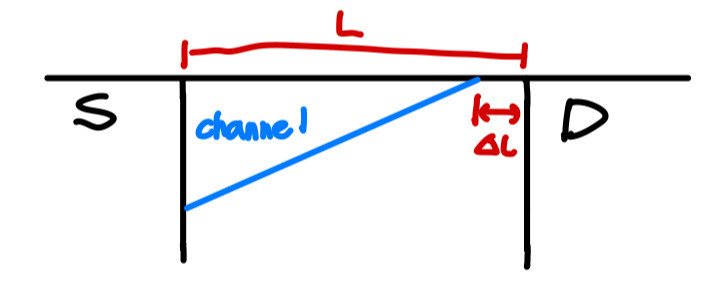
- short channel의 경우, Saturation 영역에서 전류가 saturation 되지 않고, VD가 증가함에 따라 증가
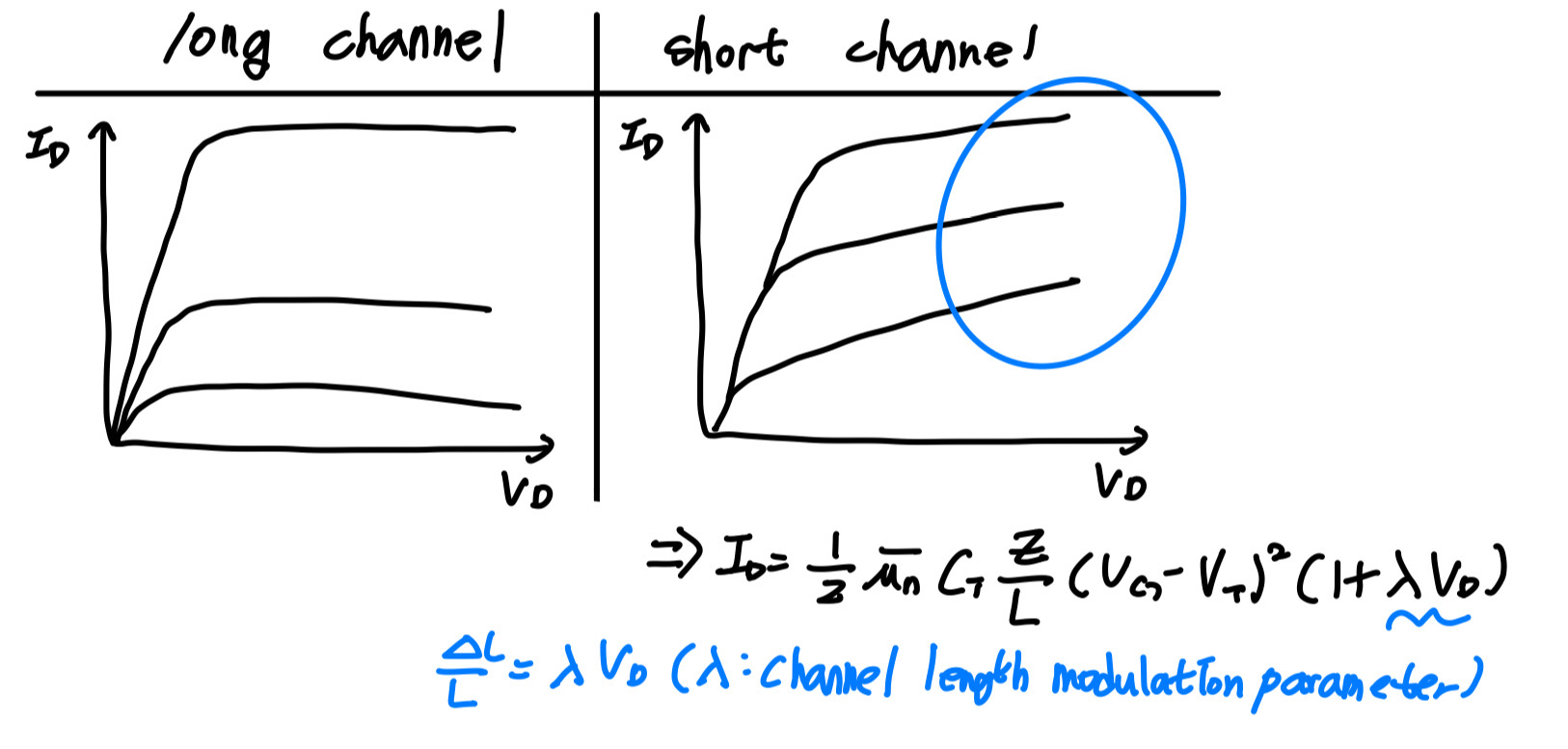
<VT roll-off>
- 채널 길이가 감소함에 따라 VT 감소
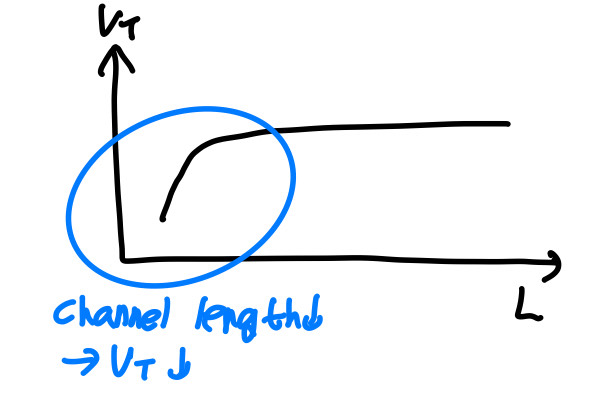
- charge sharing
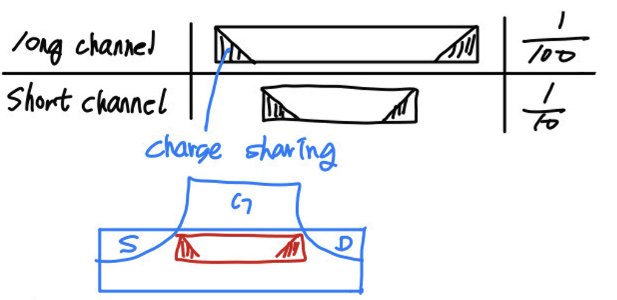
=> Short channel의 경우, gate는 일을 덜 해줘도됨
(∵Source와 Drain이 하는 일 증가)
-> 가해주는 전압이 적어도 채널이 유도됨
'MOSFET' 카테고리의 다른 글
| Advanced MOSFET Structure (0) | 2024.01.26 |
|---|---|
| 문턱전압조절 (0) | 2024.01.26 |
| MOSFET ID-VD 특성 / ID-VG 특성 (0) | 2024.01.26 |
| MOS cap C-V 특성 (0) | 2024.01.26 |
| 이상적인 MOS cap (0) | 2024.01.26 |



